 半導体製造装置や材料の展示会「セミコン・ジャパン2010」が12月1日~3日、幕張メッセ(千葉市美浜区)で開催された。韓国、台湾の半導体デバイスメーカー、ファウンドリー(受託生産会社)と競争力向上からは、集積度を上げる回路線幅の微細化やの出展各社のブースには回路線幅の微細化に対応した装置に加え、ウェハーサイズの大面積化、チップやセルを縦に積み上げる3次元構造化などに対応する装置や部品・材料が多数展示された。
半導体製造装置や材料の展示会「セミコン・ジャパン2010」が12月1日~3日、幕張メッセ(千葉市美浜区)で開催された。韓国、台湾の半導体デバイスメーカー、ファウンドリー(受託生産会社)と競争力向上からは、集積度を上げる回路線幅の微細化やの出展各社のブースには回路線幅の微細化に対応した装置に加え、ウェハーサイズの大面積化、チップやセルを縦に積み上げる3次元構造化などに対応する装置や部品・材料が多数展示された。
各所で求められる微細化技術
半導体メモリーで見ると、パソコンでは読み書きが速いDRAMが、携帯電話などではデータ保存でき、消費電力が低いNAND型フラッシュメモリーが主流。DRAMではエルピーダメモリが40nmプロセスを導入、NAND型フラッシュでは韓国サムスン電子、東芝などが32nmプロセスを導入している。こうした回路線幅の微細化では、回路を焼き付ける露光光源の短波長化が進められ、65nmプロセスからは波長193nmのフッ化アルゴン(ArF)エキシマレーザーが用いられている。また投影レンズの明るさNA(開口数)を向上し解像度を高める手法として、45nmプロセスからは投影レンズとウェハーの間に純水を満たし光の屈折率を向上させる液浸技術が採用されている。さらに32nmプロセスではArF液浸で2回露光を実施するダブルパターニングが用いられている。
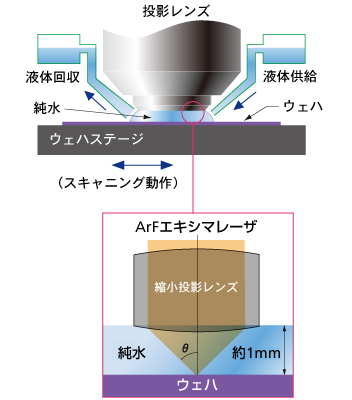 提供:ニコン 露光装置で、レチクルのパターンを投影するレンズは1/4の縮小倍率では、レチクルステージはウェハーステージの4倍の速度でスキャン動作を行い、ウェハー上に微細なパターンを焼き付けていく。ステッパーでは1時間あたりに処理できるウェハー枚数をいう「スループット」の向上が課題で、レチクルステージには露光を開始する位置に高速に移動し、高精度に位置決めする必要がある。そこでレチクルステージは磁気浮上型リニアアクチュエータなどで案内、そのXY平面の位置をレーザ干渉計で0.25~1nm程度の分解能で常時検出、Z軸方向の位置は多点焦点位置検出系からなるフォーカスセンサによって計測し、それらの計測値に基づき高精度に制御・駆動される。また、 ウェハーを搭載するウェハーステージは、リニアモータ駆動により、エアで浮上させ非接触としたエアベアリングで支持されリニアエンコーダーシステムにより位置が計測され高精度に制御・駆動される。
提供:ニコン 露光装置で、レチクルのパターンを投影するレンズは1/4の縮小倍率では、レチクルステージはウェハーステージの4倍の速度でスキャン動作を行い、ウェハー上に微細なパターンを焼き付けていく。ステッパーでは1時間あたりに処理できるウェハー枚数をいう「スループット」の向上が課題で、レチクルステージには露光を開始する位置に高速に移動し、高精度に位置決めする必要がある。そこでレチクルステージは磁気浮上型リニアアクチュエータなどで案内、そのXY平面の位置をレーザ干渉計で0.25~1nm程度の分解能で常時検出、Z軸方向の位置は多点焦点位置検出系からなるフォーカスセンサによって計測し、それらの計測値に基づき高精度に制御・駆動される。また、 ウェハーを搭載するウェハーステージは、リニアモータ駆動により、エアで浮上させ非接触としたエアベアリングで支持されリニアエンコーダーシステムにより位置が計測され高精度に制御・駆動される。
ArF液浸ダブルパターニング露光装置では高い重ね合わせ精度が必要で、32nmプロセスでは2nm以下の重ね合わせ精度が必要となる。たとえばニコンの液浸露光装置S620Dではステージ位置決めの高精度化のため、高精度エンコーダーとレーザ干渉計のハイブリッドシステムを採用している。これにより2nm以下の重ね合わせ精度と、1時間あたり200枚といった高スループットが実現されている。
大面積化に対応する各技術
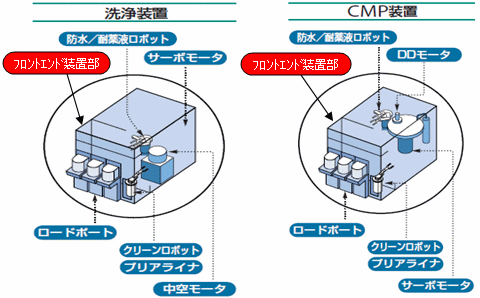 提供:安川電機 微細化の一方で1ウェハーあたりのチップ収量を上げるため、すでに300㎜ウェハーのラインが構築され大口径化が進んでいるが、これに対応した搬送系の機構では、大口径化しつつ薄厚化したウェハーのたわみや反りによる負荷を低減することが求められる。これに対したとえば京セラのウェハーハンドリングアームでは、ウェハーへのダメージの緩和や不純物の拡散防止などを目的に、DLC(ダイヤモンドライクカーボン)コーティングなどを基材のセラミック表面に被膜している。またそれぞれ微細化したチップへのコンタミの付着防止が求められ、に用いられる軸受では、CVD成膜装置など高真空環境でのウェハー搬送用ロボットなどでは、ステンレス鋼の内外輪・玉に、銀など固体潤滑剤を被覆した軸受などが適用されている。また、半導体洗浄装置やCMP(化学的機械的プラナリゼーション)装置など水や薬液への体制が求められる環境でのウェハー搬送用ロボットでは、ステンレス鋼、セラミックス、樹脂などの耐食材料を用いた耐食軸受が適用されている。
提供:安川電機 微細化の一方で1ウェハーあたりのチップ収量を上げるため、すでに300㎜ウェハーのラインが構築され大口径化が進んでいるが、これに対応した搬送系の機構では、大口径化しつつ薄厚化したウェハーのたわみや反りによる負荷を低減することが求められる。これに対したとえば京セラのウェハーハンドリングアームでは、ウェハーへのダメージの緩和や不純物の拡散防止などを目的に、DLC(ダイヤモンドライクカーボン)コーティングなどを基材のセラミック表面に被膜している。またそれぞれ微細化したチップへのコンタミの付着防止が求められ、に用いられる軸受では、CVD成膜装置など高真空環境でのウェハー搬送用ロボットなどでは、ステンレス鋼の内外輪・玉に、銀など固体潤滑剤を被覆した軸受などが適用されている。また、半導体洗浄装置やCMP(化学的機械的プラナリゼーション)装置など水や薬液への体制が求められる環境でのウェハー搬送用ロボットでは、ステンレス鋼、セラミックス、樹脂などの耐食材料を用いた耐食軸受が適用されている。
半導体製造プロセスでは、さらに米Intel、韓国サムスン電子、台湾TSMCなどが現在の1.5倍となる450㎜ウェハーへと大口径化を進めている一方で、TSMCなどが2Xnmプロセスを導入し始めている。これら次世代プロセスに対し、搬送系などのメカにはさらなる高精度でクリーンな稼働が求められている。


